Contents
1. FIB에 대해
2. FIB 활용분야
3. FIB 원리
4. FIB의 종류 (장,단점)
5. 용어
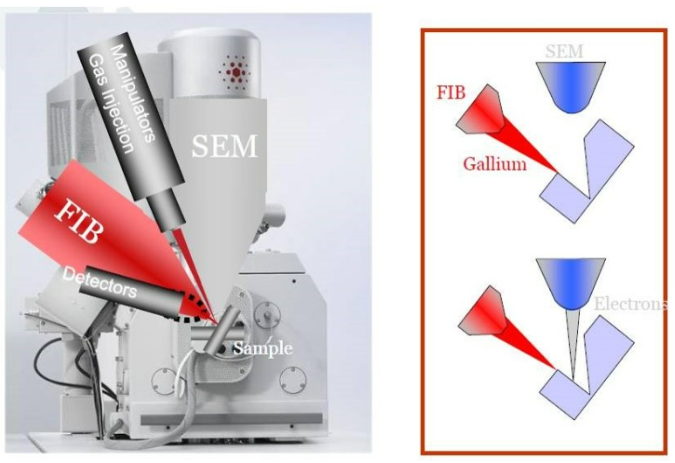
=====FIB에 대해=====
FIB는 Focused Ion Beam의 약자로, 집중된 이온 빔을 이용하여 물질을 가공하거나 조작하는 고급 분석 및 가공 기술입니다. FIB는 일반적으로 SEM과 같이 사용되며, SEM과 마찬가지로 이온을 이용하여 이미지를 생성합니다. 하지만 SEM은 전자를 이용하고, FIB는 이온을 이용하여 샘플의 표면을 가공하거나 조작합니다. 이온 빔은 높은 에너지를 가지고 있으므로, 샘플에 충돌하면서 샘플의 표면을 가공하거나 재료를 제거할 수 있습니다.
FIB는 다양한 분야에서 활용됩니다.
가장 일반적인 용도는 미세 전자공학 및 재료 과학 분야에서의 재료 가공입니다.
FIB를 사용하면 나노 레벨의 구조물을 만들거나, 샘플 내부의 미세한 구조를 조작하거나, 나노 메커니즘을 연구할 수 있습니다. 또한, FIB는 실험실에서 실험적으로 만들어진 나노 장치, 기계, 회로 등을 만들 때도 사용됩니다.
FIB 기술을 사용하는 대표적인 회사로는 FEI company, JEOL, Hitachi, Zeiss 등이 있으며, 이 회사들은 FIB 장비를 제조하고 판매합니다. 이들 회사의 웹사이트를 방문하면, 각각의 장비의 기술적인 사양과 다양한 활용 사례를 찾아볼 수 있습니다. FIB 기술은 다양한 분야에서 활용되고 있습니다.
예를 들어 반도체 제조 분야에서는 FIB를 이용하여 반도체 칩의 결함을 조사하거나, 회로 패턴의 미세 조정을 수행할 수 있습니다.
또한, 나노 머티리얼 연구 분야에서는 FIB를 이용하여 나노 구조체를 만들거나, 나노 구조체의 물리적 특성을 조사할 수 있습니다.
생물학 분야에서도 FIB를 이용하여 세포 내부의 구조를 조사하거나, 생물 샘플에서의 탐침을 수행할 수 있습니다. FIB 기술을 이용한 장비는 다양한 회사에서 제조하고 있습니다. 대표적인 제조사로는 FEI, Zeiss, Hitachi, Tescan 등이 있습니다. 이들 제조사의 FIB 장비는 각각 고유한 특징과 기능을 가지고 있으며, 연구 분야와 용도에 따라 선택할 수 있습니다. FEI (Thermo Fisher Scientific)는 FIB-SEM 기술에서 선두적인 위치를 차지하고 있으며, Helios 및 Helios G4 시리즈와 같은 다양한 FIB 장비를 제공하고 있습니다. 이들 제품은 다양한 애플리케이션에 적합한 고성능을 제공하며, 연구 분야와 용도에 따라 선택할 수 있습니다.
FEI의 공식 웹사이트에서는 제품에 대한 자세한 정보와 기술 지원을 제공합니다.
Zeiss는 Crossbeam 시리즈와 같은 고급 FIB-SEM 시스템을 제공하며, 다양한 연구 분야에서 사용됩니다. 이들 장비는 고해상도 이미징 및 분석을 위한 다양한 기능을 제공하며, 사용자가 재료 및 생물학적 샘플에서 세밀한 조작을 수행할 수 있습니다. Zeiss의 공식 웹사이트에서는 제품 정보와 기술 지원을 제공합니다. Hitachi는 각종 산업 분야에서 활용되는 다양한 FIB 장비를 제공합니다. S-4500 및 S-4800 시리즈와 같은 FIB-SEM 시스템은 높은 해상도와 고급 분석 기능을 제공하며, 다양한 연구 분야에서 사용됩니다. Hitachi의 공식 웹사이트에서는 제품 정보와 기술 지원을 제공합니다.
=====FIB 활용분야=====
FIB 기술은 다양한 분야에서 활용되고 있습니다. 반도체 산업에서는 FIB 기술을 이용하여 실험적인 반도체 칩을 만들고, 결함을 찾거나 수정하는 등의 작업을 수행합니다. 또한, 나노기술 분야에서는 FIB 기술을 이용하여 나노 디바이스를 만들어내는 연구가 진행되고 있습니다.
또한, 소재 연구에서는 FIB 기술을 이용하여 소재 내부의 결함이나 미세한 구조를 연구하는 등의 분석 작업에 사용됩니다. FIB 기술은 높은 정밀도와 확장성을 가지고 있기 때문에 다양한 분야에서 활용됩니다. FIB 기술은 SEM, TEM 등 다양한 분석 기술과 연계하여 사용될 수 있으며, 다양한 애플리케이션에 적용 가능한 강력한 도구로 자리잡고 있습니다. FIB 기술은 최근에도 계속 발전하고 있습니다. 특히, FIB를 이용한 나노 가공 기술은 나노 기술 분야에서 핵심적인 역할을 하고 있습니다. 최근에는 FIB 기술에 플라즈마 기술을 적용하는 연구가 진행되고 있습니다.
이를 통해 FIB 가공시 발생하는 가열 및 이온 충돌로 인한 손상을 최소화하고, 가공 속도와 정확도를 향상시킬 수 있습니다. 또한, 플라즈마 기술은 샘플 표면 처리나 측정 공간 내부 청소 등 다양한 분야에서도 활용될 수 있습니다.
또 다른 발전 방향으로는 FIB에 사용되는 이온원인 Ga 이온 대신 He 이온 등을 사용하는 기술이 연구되고 있습니다.
He 이온은 Ga 이온보다 더 적은 손상과 부식을 유발하며, 소프트 랜딩과 같은 가공 기술에 더 적합하다는 장점이 있습니다. 이러한 기술을 통해 나노 가공의 정확도와 효율성이 대폭 개선될 것으로 기대됩니다. FIB 기술을 적용하는 회사로는 FEI, Zeiss, Hitachi 등이 있습니다. 이들 회사의 사이트를 통해 FIB 기술에 대한 보다 자세한 정보를 얻을 수 있습니다.
최근 FIB 기술에서는 다양한 분야에서 응용됩니다.
예를 들어, 나노 머신, 광전자 소자, 바이오 메디컬, 재료 및 나노 전자학 분야 등 다양한 분야에서 사용됩니다.
또한, FIB 기술의 발전으로 인해 다양한 새로운 기술이 개발되고 있습니다. 예를 들어, FIB-TEM 연계 기술은 원자 수준에서의 분석을 가능하게 하고, FIB-SEM-TMA 기술은 샘플을 고정시켜서 보다 정확한 분석을 가능하게 합니다. 또한, FIB 기술은 높은 에너지를 필요로 하기 때문에, 에너지 공급이 어려운 환경에서의 응용이 어렵습니다. 이러한 문제를 해결하기 위해 FIB 기술을 플라즈마 기술과 결합시켜 FIB-Plasma 혹은 P-FIB라고 불리는 새로운 기술이 개발되고 있습니다. P-FIB 기술은 FIB 기술에 비해 에너지 소모가 적고, 다양한 샘플에 적용이 가능하여 더욱 유용한 기술로 평가되고 있습니다. 또한, FIB 기술에서는 Ga 이온을 주로 사용하였지만, 최근에는 Xe 플라즈마 이온을 사용하는 기술도 개발되고 있습니다.
Xe 플라즈마 이온은 Ga 이온에 비해 높은 에너지 및 전류 밀도를 가지고 있어서 더욱 정밀하고 빠른 샘플 가공이 가능합니다. 최근 FIB 기술의 발전은 다양한 분야에서의 응용 가능성을 더욱 넓히고 있습니다. 더욱 정밀하고 빠른 FIB 기술이 개발되어 미래의 나노 기술과 재료 연구 등 다양한 분야에서 활용될 것으로 기대됩니다. FIB 기술의 발전은 미래의 나노 기술과 재료 연구뿐만 아니라, 반도체, 전자 기기, 에너지, 의학, 생명 과학 등 다양한 분야에서도 활용될 것으로 예상됩니다. 특히, FIB를 이용한 나노 가공 기술은 나노 전자공학 분야에서 매우 중요한 역할을 합니다. 나노 가공 기술은 나노 반도체 제조, 나노 재료 제조, 나노 센서 제조 등 다양한 분야에서 필요합니다.
FIB 기술을 이용한 나노 가공 기술은 더욱 정교한 나노 패턴을 만들어낼 수 있으며, 고감도 센서, 반도체 소자, 기능성 나노 구조체 등 다양한 응용 분야에서 사용될 수 있습니다. 또한, FIB 기술은 생명 과학 분야에서도 큰 역할을 합니다. 생물학적 샘플의 구조와 상호작용을 이해하기 위해 나노 크기의 구조체를 만들어내는 것이 중요합니다. 이를 위해 FIB 기술은 생물학적 샘플의 가공에도 적용되어, 세포 내부의 조직, 단백질, DNA 등을 연구하는데 사용됩니다.
또한, FIB 기술은 에너지 분야에서도 활용될 수 있습니다. 태양광 전지, 연료전지 등 다양한 에너지 관련 재료의 나노 구조를 만들어내는 것이 가능하며, 이를 통해 높은 효율의 에너지 변환 장치를 개발할 수 있습니다. 이처럼 FIB 기술은 다양한 분야에서 활용 가능한 기술로 발전하고 있으며, 앞으로 더욱 많은 분야에서의 응용 가능성이 있을 것으로 기대됩니다.
=====FIB 원리=====
FIB(Focused Ion Beam)는 SEM과 같은 원리로 동작하지만, 이온 광선 대신 집속된 이온 빔을 사용하여 샘플을 가공하고 분석하는 기술입니다. 따라서 FIB는 SEM보다 더 높은 분해능과 해상도를 제공하며, 더욱 높은 깊이 및 더 빠른 샘플 제작 속도를 제공합니다. FIB를 사용하여 빠르고 넓은 영역을 측정할 수 있는 방법 중 하나는 FIB-SEM 탐사입니다.
FIB-SEM 탐사는 FIB로 샘플을 조각 내고, SEM으로 표면을 검사하여 이미지를 획득하는 과정을 반복하여 3차원 이미지를 생성하는 방법입니다. 이 방법을 사용하면 대상 샘플의 크기와 형태를 매우 빠르고 정확하게 파악할 수 있습니다.
또한 FIB를 사용하여 표면을 가공하고 SEM을 사용하여 샘플을 조사할 수 있으므로, 매우 높은 해상도와 깊이를 얻을 수 있습니다.
FIB를 이용한 빠른 영역 측정 방법 중 하나는 FIB-SEM tomography입니다.
이 방법은 FIB를 사용하여 샘플을 절단한 후, SEM을 이용하여 횡단면 이미지를 촬영합니다.
그런 다음 FIB로 샘플을 다시 절단하고, 이전 이미지와 다른 방향에서 SEM 이미지를 다시 촬영합니다.
이를 반복하여, 샘플의 3차원 이미지를 생성합니다. 이 방법은 높은 분해능과 세부적인 구조를 보여주는 3차원 이미지를 생성할 수 있어서, 샘플 내부의 복잡한 구조를 이해하는 데 유용합니다.
또 다른 방법은 FIB를 사용하여 샘플의 표면을 굴절하거나 부분적으로 제거하여 샘플 내부를 들여다볼 수 있도록 하는 것입니다. 이를 FIB cross-sectioning이라고 합니다. 이 방법은 샘플 내부의 구조를 더 자세히 살펴볼 수 있도록 하며, 디바이스 내부의 연결성 등을 확인하는 데 유용합니다.
또한, FIB를 이용한 in situ 실험을 수행하여, 샘플 내부에서 일어나는 변화를 실시간으로 관찰할 수도 있습니다.
이를 FIB-based in situ experimentation이라고 합니다.
이 방법은 샘플 내부에서 일어나는 반응, 결함 형성, 물리적 변화 등을 이해하는 데 유용합니다. FIB-SEM 편집 기술을 사용하면, SEM 이미지에서 원하는 부분을 선택하여 이를 FIB로 절단하고 SEM 이미지를 다시 얻어내는 과정을 반복함으로써 샘플의 표면 또는 단면을 정밀하게 제작할 수 있습니다.
또한, FIB-SEM에서는 FIB를 이용하여 샘플의 표면에 패턴을 만들거나 필요한 부분을 제거하여 원하는 형태로 수정할 수 있습니다. 이러한 편집 기술은 다양한 분야에서 샘플 제작 및 분석에 사용됩니다.
예를 들어, 반도체 산업에서는 FIB-SEM을 사용하여 소자의 구조를 정밀하게 분석하고 이를 개선하는 데 활용됩니다. 또한 생명 과학 분야에서는 FIB-SEM을 사용하여 세포나 조직 샘플의 표면 또는 단면을 정밀하게 제작하고 분석하는 데 사용됩니다.
금 소스 (Au source) : 가장 일반적으로 사용되는 소스 중 하나로, 금 선물을 이용한 메탈-오시게네이션(Metal-Organic Chemical Vapor Deposition, MOCVD) 공정으로 만들어집니다. FIB 가공에는 높은 효율성을 보이며, 높은 가공 속도와 낮은 손실을 제공합니다. 그러나 금이 비싸기 때문에 가격이 비교적 높은 단점이 있습니다.
탄화 규소 소스 (Silicon Carbide source) : FIB에서 사용되는 소스 중 하나로, 탄화 규소를 이용해 만들어집니다. 금 소스와 달리 비교적 저렴하고 안정적이며, 높은 가공 속도를 제공합니다. 또한 금 소스보다는 더 낮은 손실을 제공합니다. 하지만 금 소스에 비해 가공 효율성이 낮을 수 있습니다. 아이소토프 소스 (Isotope source) : 이온 추출 소스로도 알려져 있으며, 이소토프를 이용하여 만들어집니다. 이소토프는 FIB 가공 과정에서 전기화를 촉진하고, 이온의 집속 밀도와 가공 속도를 증가시킵니다. 이소토프 소스는 금 소스와 비교해 가공 효율성이 높은 장점이 있습니다. 그러나 금 소스보다는 높은 비용과 취급이 어렵다는 단점이 있습니다.
유기 소스 (Organic source) : 이소토프와 유사한 작동 원리를 가진 소스로, 유기 분자로 만들어집니다. 이소토프 소스보다는 비교적 저렴하게 제작할 수 있으며, 가공된 표면의 품질을 향상시킬 수 있습니다. 그러나 가공 속도가 느리고, 손실이 발생할 가능성이 있어 금 소스나 탄화 규소 소스와 함께 사용됩니다.
=====FIB의 종류 (장,단점)=====
- Xenon Plasma Focused Ion Beam (Xe PFIB)
- Gas Field Ionization Source (GFIS)
- Helium Ion Microscopy (HIM)
-Xenon Plasma Focused Ion Beam (Xe PFIB):
Xenon Plasma Focused Ion Beam (Xe PFIB)는 일반적으로 FIB 시스템에서 사용되는 Gallium Ion Source 대신 Xe 원자를 이용하여 샘플 표면을 절단하는 방법입니다.
Xe PFIB는 절단 정확도와 속도가 높아 빠른 시간 내에 넓은 면적의 샘플을 절단할 수 있으며, FIB 이미지의 높은 해상도와 함께 시료의 깊이 프로파일링 및 분석이 가능합니다.
장점: 절단 정확도와 속도가 높아 빠른 시간 내에 넓은 면적의 샘플을 처리 가능 높은 해상도의 FIB 이미지 품질을 보유하고 있음 다양한 시료 형태와 두께에 적용 가능
단점: Xe PFIB 소스의 가격이 높아 다른 FIB 소스에 비해 더 비싼 경향이 있음 샘플 대비 부착 및 손상 위험이 있음
-Gas Field Ionization Source (GFIS):
Gas Field Ionization Source (GFIS)는 기체 분자를 이용하여 이온화된 입자를 생성하여 샘플을 가공하는 FIB 기술입니다.
GFIS는 Ga FIB와 비교하여 이온화된 입자의 에너지가 낮아 샘플 표면에 더 적은 손상을 유발하며, 이미지 해상도와 시료 대비 부착 위험도가 감소하는 것으로 알려져 있습니다.
장점: 낮은 에너지 입자를 사용하기 때문에 샘플 표면에 적은 손상을 유발 이미지 해상도 및 시료 대비 부착 위험도가 감소 단점: 다른 FIB 소스 대비 부하 용량이 낮아 큰 표면 면적의 샘플 가공에 한계가 있음 분석에 필요한 입자 플럭스가 낮아 분석 시간이 늘어날 가능성이 있음
-HIM Helium 이온을 사용하기 때문에 전자 궤도 크기가 작아 SEM보다 더 섬세한 이미지를 제공할 수 있습니다.
또한 He 이온의 질량이 작기 때문에 샘플 표면을 손상시키는 위험이 적어 FIB와 같은 가공 기술로도 미세 가공이 가능합니다. 또한, He 이온이 샘플과 상호작용하는 과정에서 생기는 밝은 신호를 이용하여 샘플의 화학 조성과 결함을 탐지하는데도 유용합니다. 하지만 HIM 기술도 일부 한계점이 있습니다.
예를 들어, He 이온의 질량이 작기 때문에 샘플 내부까지 침투하지 못하고 표면에 국한되는 한계가 있습니다.
또한 He 이온의 충돌로 인해 생기는 충격 파동이 샘플에 미치는 영향도 고려해야 합니다.
마지막으로, HIM은 아직 SEM과 비교하여 상대적으로 새로운 기술이기 때문에 SEM에 비해 제한된 사용 가능성을 가질 수 있습니다. HIM은 He 이온을 사용하기 때문에 SEM에서 발생하는 충돌 및 배경 신호를 피할 수 있습니다. 이는 더 높은 이미지 대비와 더 낮은 노이즈 수준을 제공합니다. 또한, HIM은 얇은 샘플에서 높은 해상도를 제공하며, SEM보다 더 높은 면층 깊이를 촬영할 수 있습니다. 하지만, HIM은 전체 샘플 이미지를 촬영하는 것이 아니라 스캔 영역에서만 이미지를 촬영하므로 샘플의 대표성을 보장하기 어려울 수 있습니다. 또한, Him의 설치 및 운영 비용이 상대적으로 높을 수 있습니다. HIM은 전통적인 SEM과 비교하여 매우 낮은 에너지 불순물 배출과 샘플 손상으로 인해 이미지 선명도가 높아집니다.
또한 HIM은 초고진동 조작 시간을 가집니다.
이는 고질량 샘플의 수명을 연장하고, 단일 원자 충돌을 제한하는 데 도움이 됩니다. HIM은 또한 기본적으로 대역 외성 검출 (BSE)과 함께 사용되는 광학렌즈를 사용합니다. HIM은 BSE가 생성되는 곳에서의 이미지를 캡처하므로, SEM의 경우와 달리 샘플 표면의 모든 물질에 대한 이미지를 캡처할 수 있습니다. 하지만, HIM의 주요 단점은 가용성이 제한적이며 비용이 매우 비싸다는 것입니다. 또한, 샘플 표면에 흡수될 수 있는 헬륨 이온의 양이 제한적이기 때문에 대규모 샘플 조작에 적합하지 않을 수 있습니다.
=====용어=====
-Secondary electrons: 전자 빔이 표면과 상호작용하면서 새로 생성되는 전자로서, 이전의 전자와 다른 에너지를 가집니다. -Backscattered electrons: 전자 빔이 표면과 상호작용하면서 다시 되돌아오는 전자로서, 표면의 원소나 밀도에 따라 전자가 반사되는 정도가 달라집니다.
-X-ray characteristic peak: 특정 원소에서 전자가 이동하면서 방출되는 X-선의 주파수로, 원소마다 고유한 주파수를 가집니다.
-Energy resolution: EDS에서 측정하는 X-선의 주파수 분해능으로서, 고에너지 X-선과 저에너지 X-선을 잘 구분할 수 있는 능력을 말합니다.
-Scanning area: SEM에서 전자 빔을 이동시키며 관찰하는 영역으로, 이 영역의 크기가 SEM 분석의 해상도에 영향을 미칩니다.
-Working distance: SEM에서 전자 빔과 샘플 사이의 거리로, 이 거리가 가까우면 분석 대상이 손상될 수 있고, 멀면 해상도가 낮아집니다. -Spectrum (스펙트럼) - EDS 분석 결과로 얻어진 데이터를 그래프로 표현한 것을 말합니다. 일반적으로 X-축은 X-선의 에너지 값을, Y-축은 각 X-선의 감지 개수를 나타냅니다.
-Peak (피크) - Spectrum 상에서 각 X-선이 나타나는 부분을 말합니다. Peak는 X-선의 에너지와 감지된 개수의 크기와 모양으로 나타납니다.
-Background (배경) - Spectrum 상에서 Peak 이외의 부분을 말합니다. 대개는 X-선이 감지되지 않은 경우입니다.
-Counts (카운트) - EDS 분석기가 한 피크에서 수집한 데이터 포인트 수를 의미합니다.
-Dead time (데드타임) - EDS 분석기에서 높은 에너지 X-선을 감지할 때 발생하는 지연 시간을 말합니다. 이는 낮은 에너지 X-선의 감지를 막아 분석 결과 왜곡을 일으키는 원인이 됩니다.
-ZAF correction (ZAF 보정) - EDS 분석에서 X-선 감지에 대한 보정 방법입니다. Z는 물체의 원소 구성, A는 각 원소의 흡수, F는 물체 내부의 양성자와 전자의 상호작용을 나타내는 보정 상수입니다.
-K-alpha line (K-알파선) - X-선 방출의 종류 중 하나로, K-껍질 전자가 L-껍질로 떨어질 때 방출되는 X-선을 말합니다. 일반적으로 가장 높은 에너지를 가지며, 가장 많은 Peak을 갖습니다.
-M-line (M-선) - X-선 방출의 종류 중 하나로, M-껍질 전자가 다른 껍질로 떨어질 때 방출되는 X-선을 말합니다. K-알파선보다 에너지가 낮습니다.
-Escape peak (이스케이프 피크) - X-선이 표적에서 흡수되지 않고 피크 아래에서 측정되는 현상입니다. 일반적으로 X-선의 2/3 에너지를 갖습니다.
-SIMS (Secondary Ion Mass Spectrometry): 샘플 표면에서 이온을 방출시키고, 이온 질량 분석법을 이용하여 샘플 내부 원소 분포를 분석합니다.
-Backscattered Electron (BSE): SEM에서 전자 광선이 샘플과 충돌하여 되돌아오는 전자입니다. BSE는 샘플의 원자번호와 질량에 따라 반사되는 정도가 달라지므로, SEM 이미지에서 색상 차이를 이용하여 원소의 분포를 파악할 수 있습니다.
-X-ray: EDS에서 측정되는 전자 광선 중 하나로, 전자 광선과 샘플이 충돌하면서 샘플 내 원자가 이동하면서 방출되는 광선입니다. 각 원소마다 고유한 X-ray 스펙트럼을 가지고 있으므로, 이를 이용하여 샘플 내 원소의 존재 및 양을 파악할 수 있습니다.
-Energy resolution: EDS에서 측정된 X-ray의 에너지 분해능을 나타내는 지표입니다. 측정된 X-ray의 에너지와 실제 X-ray의 에너지 간의 차이가 작을수록 높은 Energy resolution을 갖게 됩니다.
-Count Rate: SEM-EDS에서 X-ray Detector로부터 수집된 X-ray 신호의 총 갯수를 말합니다. 높은 Count Rate는 더 높은 분석 속도를 의미합니다.
-Electron gun: SEM에서 전자를 발생시키기 위한 소스로 총알과 같은 모양을 하고 있는 부품입니다.
-Cathode: Electron gun에서 전자를 방출하는 음극입니다.
-Anode: Electron gun에서 전자를 가속시키기 위한 양극입니다. -Beam current: SEM에서 샘플 표면을 스캔할 때 전자 광선의 세기나 양을 나타내는 값입니다.
-Beam voltage: SEM에서 전자 광선에 가해지는 전압을 나타내는 값입니다.
-Backscattered electron (BSE): SEM에서 전자 광선이 샘플 표면과 상호작용하여 샘플에서 튕겨져 나온 전자를 수집해 분석하는 방법입니다.
-Scintillator: SEM에서 샘플에서 방출된 전자를 감지하기 위한 광학 부품입니다.
-Photomultiplier: SEM에서 Scintillator에서 방출된 빛을 감지하고 증폭하여 전자 신호로 변환해주는 부품입니다.
-Accelerating voltage: EDS에서 전자를 가속시키기 위한 전압입니다.
-Detector: EDS에서 X-선을 감지하는 부품입니다.
-Energy resolution: EDS에서 X-선의 에너지를 정확하게 측정할 수 있는 능력을 나타내는 값입니다.
'공학,과학' 카테고리의 다른 글
| [KOR] [공학,과학] 슈뢰딩거 방정식 (36) | 2023.10.15 |
|---|---|
| [KOR] [공학,과학] 양자역학 (I) (37) | 2023.10.05 |
| [KOR] [상식] 미사일과 로켓 (위성발사체) (86) | 2023.09.01 |
| [KOR] [과학,공학] 초전도체 (63) | 2023.08.05 |
| [KOR] [자동차] 전기 자동차 (NACS와 CCS) (6) | 2023.07.30 |